Through glass via (TGV)
Outline
3-dimensional wafer-level-packaging (WLP) is the most suitable for miniaturizing semiconductor devices. It also can improve the high-frequency properties of the devices with the metal via.
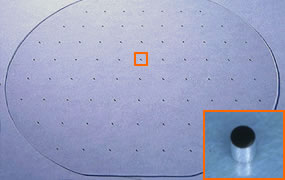
Features
Through glass via makes it possible to minimize devices
Anodic bonding with a silicon wafer is available
Non-adhesive process can solve the out-gas issue
Excellent high-frequency properties, ideal for RF application
- Low stray capacitance compared with TSV
- Low inductance
- Low electric-resistance (due to metal rods)
Suitable for WL-CSP MEMS packaging
Fine via pitch tolerance
- Consecutive pitch <±20μm/φ200 mm wafer
- Consecutive Via pitch <±20μm
Available up to φ200mm wafers
※Please scroll to the side.
| Standard specifications | ||
|---|---|---|
| Material | Borofloat 33, SW-YY | |
| Glass size | ≦φ200mm | |
| Min. thickness | 0.3mm | |
| Min. Via diameter | φ0.15mm | |
| Hole size tolerance | ±0.02mm | |
| Max. aspect ratio | 1 : 5 | |
| Via material | Si、W(Tungsten) | |
| Via hermeticity ( He leak test ) | 1×10-9 Pa・m3/s | |
| Via-Glass gap | Std. | 0μm〜3.0μm |
| Option 1 | 0μm〜1.0μm | |
| Option 2 | -3.0μm〜0μm | |
| Via shape | Straight | |
| Cavity process | Available | |
| Metallization process | Available | |
| Bump process | Available | |
Note: These are standard specifications.
In case you have any request for other than the above, please feel free to contact us.
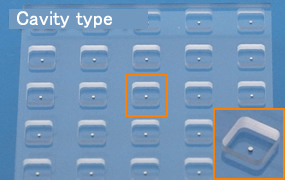

TGV application sample
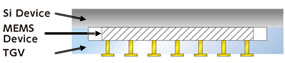
End user market / Applications
AV/Mobile
- RF-switches/relays for mobile devices such as smartphones, portable video games, digital cameras, car navigation systems,
Pressure sensors, Gyroscopes, Acceleration sensors, image sensors
Automotive
- Pressure sensors, Acceleration sensors.
- Gyroscopes,etc
Semiconductors
- RF-MEMS switches.
- Image sensors,etc
Biotechnology/Medical
- Pressure sensors for medical devices,etc
